IGBT同时集MOSFET易驱动和BJT大电流两个显著特点于一身,因此在新能源、高铁、智能电网、电动汽车这些绿色产业中成为不可或缺的核心功率器件。
IGBT通常为单向器件,自身不具备逆向导通能力,在大部分的IGBT应用电路中,都需要反并联二极管(续流二极管,FRD)进行保护。
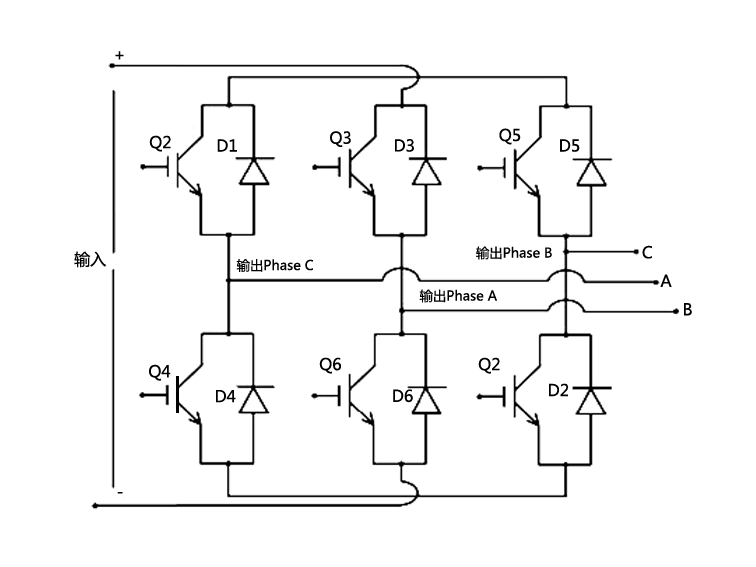
图1 IGBT的一种常用应用电路:三相逆变电路
图1是一种常用的三相逆变电路。早期且现在仍在采用的做法是分别制作IGBT和二极管,再将两者封装在一起,做成IGBT模块。
这样的做法使IGBT模块寄生电感较高、集成度较低。为降低成本、提高芯片的功率密度,IGBT与二极管同时在集成同一个硅片上的逆导型IGBT(Reverse Conducting IGBT, RC-IGBT)相继问世以后,RC-IGBT已有取代传统集成封装IGBT、二极管对的趋势。
下面将为大家逐步揭开RC-IGBT的神秘面纱。
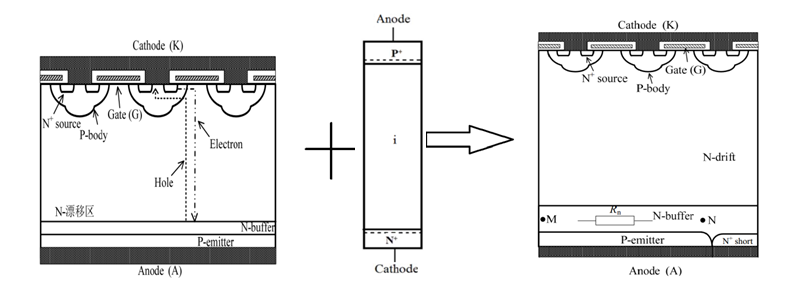
图2 RC-IGBT示意图
图中左、中、右图分别为传统IGBT、二极管和RC-IGBT的结构示意图。图中的RC-IGBT为双向导电IGBT基本的结构。
该结构基于IGBT的薄片工艺,将二极管的阴极集成到IGBT的阳极中,于是传统IGBT的阳极就变成了P区、N区周期性交替排列的结构。而二极管的阳极为传统IGBT的P-body区,如图2中所示。
当RC-IGBT正向导通时,阳极P-emitter区向N-drift区注入少数载流子空穴,电流从IGBT阴极流出;而当RC-IGBT反向导通时,器件的电流由正向导通的二极管传导,即电流从RC-IGBT阳极中n+区流出。
然而,该RC-IGBT结构存在一些亟待解决的问题,例如,正向导通时有电压折回(Voltage snapback)现象(如图3所示),反向恢复性能差和漂移区电流分布不均匀等。这些问题是RC-IGBT产品广泛应用的障碍。

图3 电压折回输出曲线示意图
这次我们先为大家介绍几种为解决RC-IGBT电压折回现象而提出的新型结构,关于其他问题的优化方案和理念后续再逐步介绍。
为了能更好的理解电压折回现象,我们首先对其成因进行一下分析。
RC-IGBT正向导通初期(发生电压折回之前),图2中N-buffer与N+short相连,P-emitter/N-buffer结短路,RC-IGBT体内只有由表面MOS结构流入的电子电流。该电流流经N-buffer区,最终从N+short流出(工作机理类似VDMOS,称之为VDMOS模式)。电流分布如图4所示。
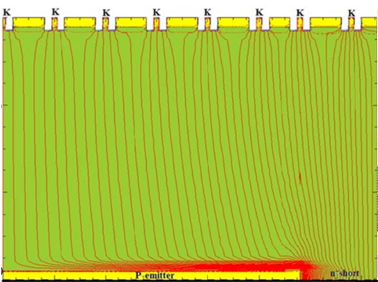
图4 电压折回前电流分布示意图
此时,由于P-emitter区不能向N-drift区注入空穴,N-drift区也没有电导调制效应存在,因此RC-IGBT发生电压折回之前的导通电阻非常大。由于N-buffer区扩展电阻Rn的存在,电子电流在该路径上会产生电压降VNM(N点、M点如图2中所示)。
当A、M两端的电压降VAM等于P-emitter/N-buffer结的内建电势时,M点附近的P/N结开始正偏,部分P-emitter开始向N-drift区注入空穴,使其发生电导调制效应,电阻开始降低。RC-IGBT电压开始折回时的阳极电压VAK为VSB,如图3所示。
由于RC-IGBT电流的增加,M至N点之间的电势进一步降低,致使该处的 P-emitter/N-buffer 结逐渐正偏,这样就有更多的空穴注入N-drift区,电导调制效应增强,从而形成电流不断增大而电阻不断减小的正反馈过程,直至P-emitter/N-buffer 结完全正偏(工作机理为IGBT,称之为IGBT模式)。这个电流增大的同时电压降低过程反映到输出特性曲线,即为 RC-IGBT的电压折回现象。
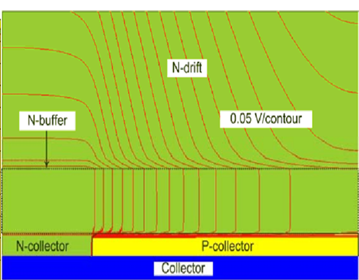
图5 IGBT工作模式下的电流分布示意图
从上面分析我们可以看出,电子电流横向流经上的电阻Rn的阻值越大,M点处的P-emitter/N-buffer结会越早开启,N-drift区会越早发生调制效应,从而使得器件从VDMOS模式越快进入IGBT模式。
因此,Rn的阻值会直接影ΔVSB=VSB-VH大小。ΔVSB是电导调制效应带来的阳极电压减小幅度,也是能反映电压 snapback 程度的一个关键参数。可以认为当ΔVSB=0时,电压折回现象消失。
下文将为大家简要介绍四种基于以上分析理念(提高电子流经路径上电阻Rn的阻值)而实现snapback-free的RC-IGBT。
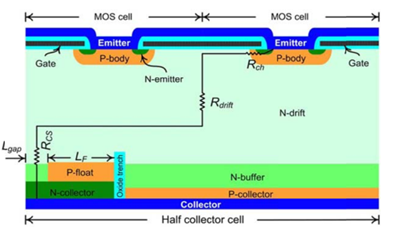
图6 具有浮空P区的RC-IGBT
图6为具有浮空P区的RC-IGBT结构示意图。该结构阳极区存在一浮空P区。当RC-IGBT正向导通且处于VDMOS模式时,该区域形成的势垒阻挡电子从此区域穿过,而将其限制在图中所示的窄通道,即Lgap所指区域。这样就增加了电子电流流通路径上的电阻,有效抑制了snapback现象,并且比传统RC-IGBT具有更小的下降时间和关断损耗。
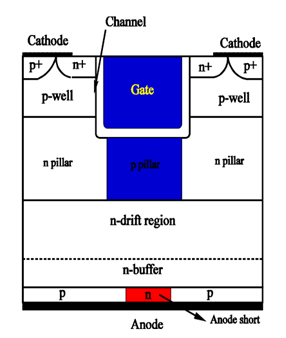
图7 具有半超结的RC-IGBT
图7为RC-Semi SJ IGBT结构示意图。该结构的设计者一改惯用思维方式,另辟蹊径。采用半超结结构降低器件漂移区电阻,从而增加N-buffer扩展电阻Rn在总电阻中的比重,使得阳极P/n-buffer结电压降大于内建电势而正偏。
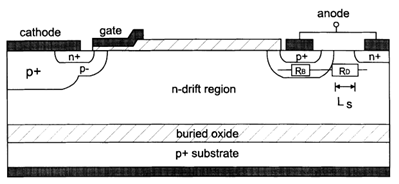
图8 Separated anode-shorted LIGBT示意图
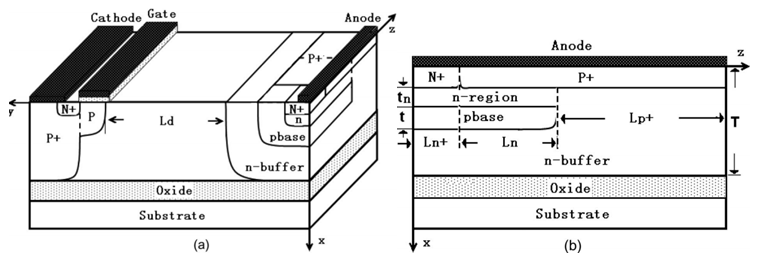
图9 3-D n-region-controlled anode LIGBT示意图;(a)结构图;(b)截面示意图
以上讨论的理念同样可以应用在横向器件中,图8和图9均为RC-LIGBT结构示意图。两种结构均利用高阻的N-drift代替传统低阻的N-buffer区作为电子电流的流通通道以增加Rn,来降低折回电压。不同之处在于图9中的结构对该区域电阻增加了额外的控制包括宽度tn和长度Ln,增加了器件的可调参数。
以上就是从RC-IGBT结构出发,分析RC-IGBT电压折回现象产生机理及对改进结构介绍的全部内容。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。